01.Leakage Currents in an SRAM of Conventional Design;
02.Gate-Tunnel Leakage and GIDL Currents
DRAM有较低的待机功耗,但是需要刷新操作,而SRAM则能静态的保存数据,不需要类似于刷新这样的特殊操作。因此,对于手机或移动设备中集成的SRAM芯片,我们很容易对其进行控制。此外,由于SRAM的制造工艺和CMOS工艺一样,例如移动蜂窝电话等中的应用处理器也使用SRAM作为集成的存储器。
随着MOS工艺的进步,近阈值泄漏电流(subthreshold leakage current)中会增加gate-oxide tunnel leakage和gate-induced drain leakage(GIDL)currents,成为主要的泄漏电流,增加的泄漏电流同时也增加了整个SRAM cell的静态漏电流。本小节将描述SRAM array的基本泄漏功耗。
leakage Currents in Conventional Design
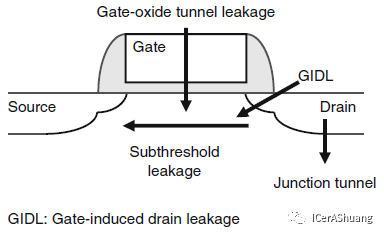
Fig.1 Leakage currents in a technologically advanced nMOS device
关于工艺进步而造成泄漏电流增加的问题,图1展示了nMos晶体管在工艺上进步产生的4种主要泄漏电流。包括gate-oxide tunnel leakage,GIDL,junction tunnel leakage以及subthreshold leakage currents.
Subthreshold leakage是当gate为off状态时,由drain到source的沟道泄漏电流,这种状态造成了在沟道区域的微弱反型层。
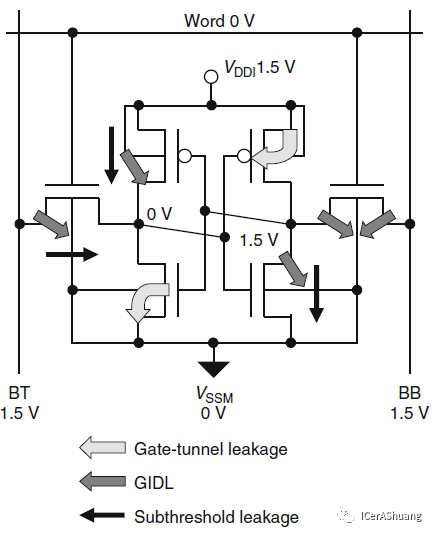
Fig.2 Standby leakagecurrents in an advanced technology SRAM cell of conventional design
图2中描述了随着工艺进步,使用传统设计方式的SRAM cell中的主要泄漏电流。在传统设计方式中,bit lines(BT,BB)和power line(VDDI)为1.5v,word line 和VSS 为0v。
在整个cell中,2个gate-tunnel leakage currents,5个GIDL currents和3个subthreshold leakage currents 组成了主要的漏电流**。**
使用高阈值电压的MOS器件能够直接有效的减少subthreshold leakage currents ,虽然存储单元的读电流也会减小。
然而,通过简单的改变器件结构很难去减小tunnel leakage 和GIDL currents.
Gate-Tunnel Leakage and GIDL Currents
这小节描述了gate-tunnel leakage 和GIDL currents。在图3中给出了gate-tunnel leakage current 随着栅压(gate voltage) 变化的曲线,同时栅氧化层厚度(Tox)作为一个参变量对比分析。
Tox 每增长2-°A,gate-tunnel leakagecurrent 会增长十倍。随着工艺的进步,这种电流成为了泄漏电流的主要组成。
另一方面,栅电流随着栅压减小而减小,减小电压0.5v(从1.5到1.0v)能减小这种泄漏电流的95%。这是因为tunnel leakage current能随着栅氧化层的电场强度变化而简单的减小。
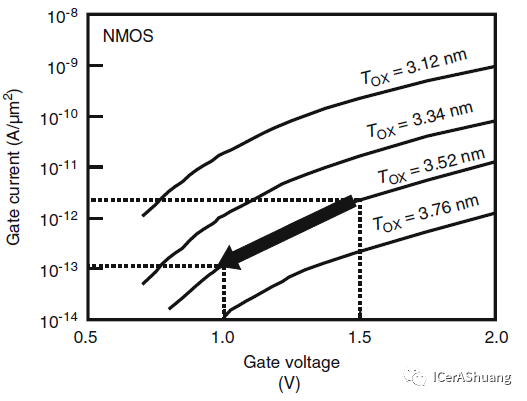
Fig.3 Gate-tunnel leakage current as a function of gate voltage with the thickness ofthe gate oxide (Tox) varied as a parameter
图4描述了漏端电流由栅电压(VG)作用的电流曲线。实线是漏端电压(VD)为1.0V时的漏端电流曲线,虚线为1.5v时漏端电流曲线。当VG大于0v时,subthreshold leakage currents 占主导地位。当VG小于0V时**,GIDL currents 占主导地位**。
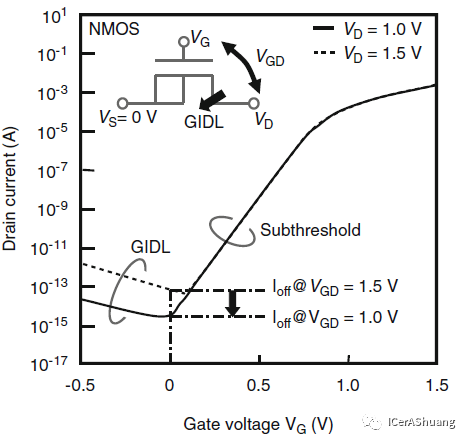
Fig.4 GIDL and subthreshold leakage currents
在使用中提升阈值电压,在VG=0v时subthreshold leakage currents 相比于GIDL current的强度是可以忽略的。
GIDL current(IGIDL)对于电场强度F非常敏感。GIDL current 对数曲线线性反比于栅压,栅压直接影响栅氧化层下的电场强度。GIDL current的大小由栅和漏的压差(VGD)决定,VGD由1.5减小到1.0v,电场强度减小,在器件中the GIDL current减小大约90%。
如果**阈值电压很低,**主要的泄漏电流是subthreshold leakage current。通过应用negative VGS,或者negativeVBB back-body bias voltage可以减小subthreshold leakage。具体实现电路和SRAM芯片架构下一期再接着介绍_
Ref:Low power and reliable SRAM memory cell and array design[M]. Springer Science & Business Media, 2011.

